レーザーIC開封装置

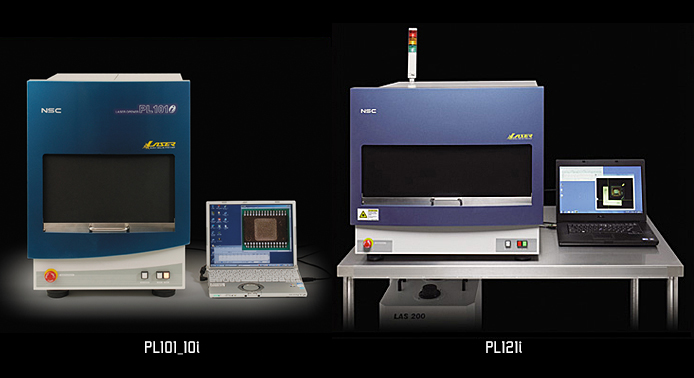
概要
レーザーオープナーPL101-10i、PL121iをリリース致しました。従来タイプと比べてより高精度加工を実現する事ができます。従来タイプのレーザーオープナーからiタイプへの改造も可能です。
レーザーIC開封機 特徴
薬品開封・ドライ開封前処理
近年、プラスチップパッケージの封止樹脂材はますます強酸で溶解しづらく、また、ボンディングワイヤー等の配線材はますます強酸に侵されやすくなってきています。また環境面からも強酸を使用することを嫌う傾向にあります。レーザーをダイに直接当てるとダイにダメージを与えるため、ダイ表面の樹脂をレーザー処理によって100um以下まで落すことにより、薬液使用量・薬液処理時間を大幅に減らす事が可能です。ドライ開封時間も同様にレーザー前処理することにより短縮。その結果、加工ダメージの少ないサンプル処理が実現できます。CuワイヤーIC、AgワイヤーIC、酸での溶解が困難な樹脂のIC開封に大変有効です。
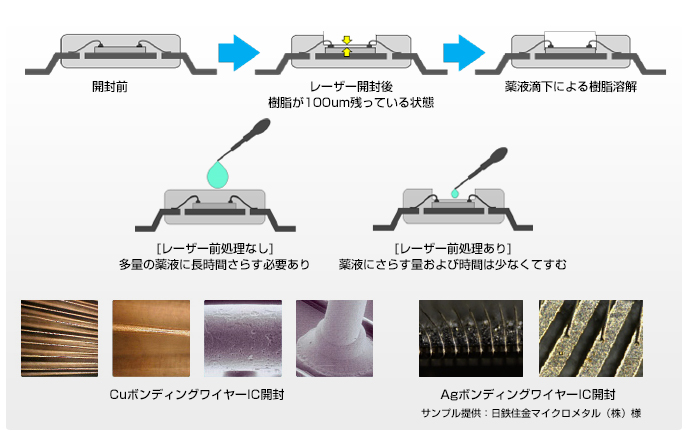
2次側の開封
BGAパッケージなどのパッケージ基板表面はソルダーレジスト膜で保護されています。この膜は薬液により損傷しやすいために、2次側レジスト部分を薬液ダメージなしで観察したい場合は、レーザーオープナーによる開封が適しています。薬液を使用せずレーザーのみで加工が可能です。

裏面観察の前処理
ICの不良解析実施時など、パッケージ裏面からエミッション顕微鏡観察やIR-OBIRCH解析を行いたい場合、ダイ裏面を露出させる必要があります。レーザーオープナーで樹脂を除去することによりリードフレームの除去を短時間で行うことができます。

豊富な加工パターン
高出力処理と低出力処理の組合せ、さらに切断処理まで幅広い加工パターンをお選びいただけます。PL101_10i、PL121iの10Wタイプでは、基板を切断することも可能です。セラミックパッケージ品のカバーも切断除去することが可能です。もちろん接着材によって接着された金属カバーも短時間で開封可能です。BGAパッケージの断面観察にも有効であり、幅広い用途が期待できます。

大型(PL121i)厚物サンプル処理(PL101_10i・PL121i)
ハイブリッド車、電気自動車、太陽光発電で使われるパワー系半導体モジュールやIGBT等、大型かつ厚物サンプルを迅速に処理することを可能にしました。
“ i “シリーズ 特徴
より微細なIC開封を可能にしました。パッケージサイズ0.5mm以下のサンプル加工実績があります。
ズーム機能を搭載
デジタルズームにより2倍、3倍の2段階ズーム、1/2、1/3の2段階ズームアウトで加工範囲を指定できます。
鮮明な画像
高解像度レンズを搭載しています。内部照明も輝度が向上し、細部をより鮮明に確認可能です。
自動高さ測定機能
測定用レーザーによって、加工量を自動で測定します。連動して、ステージがZ軸方向に移動する為、従来機よりもさらに適切なレーザー焦点距離を保って加工できます。また、自動停止機能を使用して加工前に加工高さを指定入力することによって、指定高さで自動停止します。チップダメージをより高精度に防ぐことができます。
吸引ダクト
加工によって出た粉塵を吸引する為のダクトをステージ近くに設置しました。吸引能力が向上し、開封サンプル、装置共にクリーンな状態を保ちます。
