レーザーIC開封装置


ICを開封する際はレーザーで樹脂を低減した後、酸やプラズマでダイを露出させます。従来のレーザー開封装置で直接ダイを露出させると、ダイにレーザーによるダメージを受けます。

今回、レーザーでダメージなくダイを露出させる装置、PL201Dを開発しました。

概要
酸やプラズマを使用せずにダメージ無くダイを露出できる、世界初の新型レーザー開封装置です。
特長
従来の前処理用レーザー開封装置でチップ上の樹脂を200μm以下まで加工し、その後PL201Dでダイを露出します。
大気圧プラズマ開封装置より大幅に開封時間が短縮可能です。
必要な設備は排気口とエアーのみです。
レーザー照射と水洗浄によるフィラーの除去を全自動で行い、加工します(特許出願中)。
ダメージ対応
サンプルへのレーザーによるダメージを最小限に和らげる為の独自の機構を採用しています。
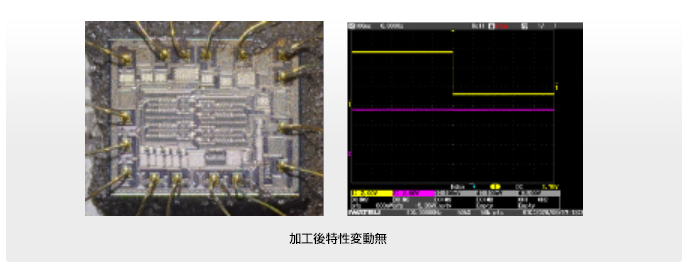
操作
簡略化されたレーザー条件を選択し、ステップごとに加工条件を入力するのみです。
加工範囲指定は数値入力と画面上加工枠のマウスドラッグ両方で行えます。
X線画像等を重ね合わせて加工範囲を指定することも出来ます。
加工範囲指定は数値入力と画面上加工枠のマウスドラッグ両方で行えます。
X線画像等を重ね合わせて加工範囲を指定することも出来ます。
安全設計
PL201DはClass 1 製品です。その他、運転管理のためのキースイッチ、インターロック、操作扉が開いた状態のレーザー発振禁止、レーザー発振時の自動扉ロック、シグナルタワー等完備しています。
開封事例